通過高光譜成像進(jìn)行薄膜厚度檢查
發(fā)布時(shí)間:2023-09-22
瀏覽次數(shù):398
厚度是薄膜和涂層的關(guān)鍵質(zhì)量參數(shù)。厚度和均勻性強(qiáng)烈影響薄膜的功能,需要精確監(jiān)控。為此,X 射線技術(shù)和光譜學(xué)在桌面和在線檢測(cè)系統(tǒng)中得到廣泛應(yīng)用。
厚度是薄膜和涂層的關(guān)鍵質(zhì)量參數(shù)。厚度和均勻性強(qiáng)烈影響薄膜的功能,需要精確監(jiān)控。為此,X 射線技術(shù)和光譜學(xué)在桌面和在線檢測(cè)系統(tǒng)中得到廣泛應(yīng)用。然而,目前僅采用點(diǎn)傳感器,并且對(duì)于在線應(yīng)用,通常安裝在掃描橫向平臺(tái)上,從而形成鋸齒形檢查圖案。因此,所檢查的膠片僅受到部分監(jiān)控。
線掃描(推掃式)高光譜相機(jī)可以克服這一限制并檢查整個(gè)膠片或涂層。在每條線捕獲中,整個(gè)膠片寬度上的光譜數(shù)據(jù)都以高空間分辨率產(chǎn)生。
為了演示此應(yīng)用中的高光譜成像,使用在 900 – 1700 nm 范圍內(nèi)工作的光譜相機(jī)測(cè)量了四個(gè)聚合物薄膜樣品。樣品薄膜的標(biāo)稱厚度為17、20(兩片薄膜)和23 um。使用鏡面幾何,并仔細(xì)檢查干涉。根據(jù)光譜位置和相長(zhǎng)干涉之間的距離,可以推斷出厚度:

λp 為波長(zhǎng),單位為 nm,其中最大值為索引 p。
n是薄膜材料的折射率
α 是鏡面設(shè)置的入射角
在鏡面反射中測(cè)量的光譜干涉圖案被轉(zhuǎn)換成厚度圖。

使用 Matlab 將光譜干擾轉(zhuǎn)換為厚度熱圖。根據(jù)光譜數(shù)據(jù)計(jì)算出的平均厚度為 18.4、20.05、21.7 和 23.9 um。標(biāo)準(zhǔn)偏差分別為 0.12、0.076、0.34 和 0.183 um。當(dāng)測(cè)量薄膜時(shí),它們沒有被拉伸。這可以解釋為什么測(cè)量值略高于標(biāo)稱值。此外,還發(fā)現(xiàn)了缺陷。在影片 1 中,我們發(fā)現(xiàn)了兩個(gè)薄樹林,可能是由局部壓力造成的。

高光譜成像將顯著提高當(dāng)前基于光譜的薄膜效率和涂層質(zhì)量控制系統(tǒng)。由于高光譜相機(jī)每秒可以采集多達(dá)數(shù)千張線圖像,因此可以對(duì)薄膜進(jìn)行 100% 在線檢測(cè),以提高質(zhì)量的一致性并減少浪費(fèi)。
與當(dāng)前基于點(diǎn)光譜儀的 XY 掃描解決方案相比,它們還將實(shí)現(xiàn)速度顯著提高的桌面檢測(cè)系統(tǒng)。高光譜相機(jī)還消除了 X 射線傳感器的有害輻射風(fēng)險(xiǎn),因?yàn)橹恍枰獰o害的光學(xué)光。
相關(guān)產(chǎn)品
-
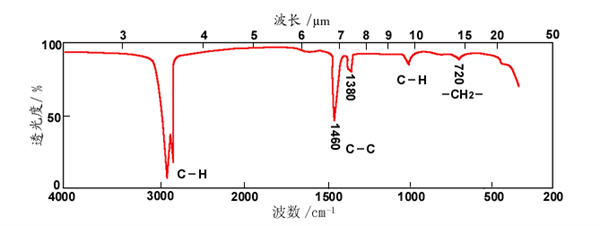
紅外光譜的發(fā)展、原理、特點(diǎn)、分類
紅外光譜的發(fā)展、原理、特點(diǎn)、分類紅外光譜的技術(shù)在各領(lǐng)域中的應(yīng)用相繼經(jīng)歷了很長(zhǎng)時(shí)期,逐漸完善著自身技術(shù)在領(lǐng)域中的應(yīng)用,且將低成本高性能作為發(fā)展與創(chuàng)新的主要方向。本..
-
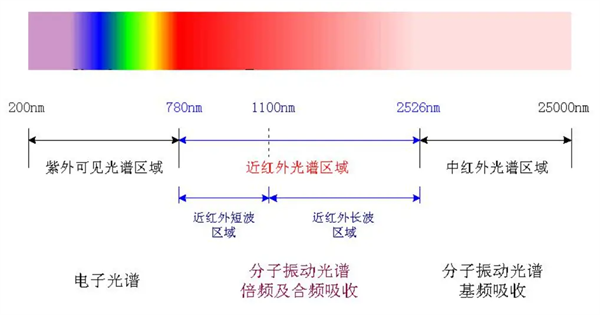
近紅外光譜技術(shù)的優(yōu)缺點(diǎn)和應(yīng)用范圍
?由于近紅外光譜在光纖中良好的傳輸性,近年來也被很多發(fā)達(dá)國(guó)家廣泛應(yīng)用在產(chǎn)業(yè)在線分析中。近紅外定量分析因其快速、正確已被列人世界谷物化學(xué)科技標(biāo)準(zhǔn)協(xié)會(huì)和美國(guó)谷物化學(xué)..
-

高光譜數(shù)據(jù)常見預(yù)處理方法有哪些?
高光譜在采集數(shù)據(jù)時(shí)會(huì)有成百上千個(gè)不同的波段數(shù)據(jù),數(shù)據(jù)量巨大從而增加了數(shù)據(jù)處理的難度。而且在高光譜圖像采集過程中會(huì)有來自儀器與環(huán)境的干擾,獲得的光譜信號(hào)易存在噪聲..
-

高光譜成像儀光譜數(shù)據(jù)特征波長(zhǎng)的選取方法介紹
高光譜成像儀?在對(duì)樣品進(jìn)行側(cè)臉時(shí),會(huì)采集多波段的光譜數(shù)據(jù),全波段數(shù)據(jù)有較多的冗余信息,因此就需要采用一定的方法來選取樣本光譜的特征波段與紋理特征的重要變量。本文..





















